ອຸປະກອນຕັດເລເຊີສອງແພລດຟອມອິນຟາເຣດ Picosecond ສຳລັບການປຸງແຕ່ງແກ້ວ Optical/Quartz/Sapphire
ພາລາມິເຕີຫຼັກ
| ປະເພດເລເຊີ | ອິນຟາເຣດ Picosecond |
| ຂະໜາດແພລດຟອມ | 700 × 1200 (ມມ) |
| 900 × 1400 (ມມ) | |
| ຄວາມໜາຂອງການຕັດ | 0.03-80 (ມມ) |
| ຄວາມໄວໃນການຕັດ | 0-1000 (ມມ/ວິນາທີ) |
| ການແຕກຫັກຂອງຄົມຊັດ | <0.01 (ມມ) |
| ໝາຍເຫດ: ຂະໜາດຂອງແພລດຟອມສາມາດປັບແຕ່ງໄດ້. | |
ຄຸນສົມບັດຫຼັກ
1. ເຕັກໂນໂລຊີເລເຊີທີ່ໄວທີ່ສຸດ:
· ກຳມະຈອນສັ້ນລະດັບ Picosecond (10⁻¹²s) ລວມກັບເທັກໂນໂລຢີການປັບແຕ່ງ MOPA ບັນລຸຄວາມໜາແໜ້ນຂອງພະລັງງານສູງສຸດ >10¹² W/cm².
· ຄວາມຍາວຄື້ນອິນຟາເຣດ (1064nm) ເຈາະເຂົ້າໄປໃນວັດສະດຸທີ່ໂປ່ງໃສຜ່ານການດູດຊຶມແບບບໍ່ເປັນເສັ້ນຊື່, ປ້ອງກັນການລະລາຍຂອງພື້ນຜິວ.
· ລະບົບແສງຫຼາຍຈຸດໂຟກັສທີ່ເປັນເຈົ້າຂອງສ້າງຈຸດປະມວນຜົນເອກະລາດສີ່ຈຸດພ້ອມໆກັນ.
2. ລະບົບການຊິ້ງຂໍ້ມູນສອງສະຖານີ:
· ຂັ້ນຕອນມໍເຕີເສັ້ນຊື່ຄູ່ທີ່ມີພື້ນຖານແກຣນິດ (ຄວາມຖືກຕ້ອງຂອງຕຳແໜ່ງ: ±1μm).
· ເວລາສະຫຼັບສະຖານີ <0.8 ວິນາທີ, ເຮັດໃຫ້ສາມາດດຳເນີນການ "ປະມວນຜົນ-ໂຫຼດ/ຍົກເຄື່ອງ" ແບບຂະໜານໄດ້.
· ການຄວບຄຸມອຸນຫະພູມເອກະລາດ (23±0.5°C) ຕໍ່ສະຖານີຮັບປະກັນຄວາມໝັ້ນຄົງຂອງເຄື່ອງຈັກໃນໄລຍະຍາວ.
3. ການຄວບຄຸມຂະບວນການອັດສະລິຍະ:
· ຖານຂໍ້ມູນວັດສະດຸປະສົມປະສານ (200+ ພາລາມິເຕີແກ້ວ) ສຳລັບການຈັບຄູ່ພາລາມິເຕີອັດຕະໂນມັດ.
· ການຕິດຕາມກວດກາພລາສມາແບບເວລາຈິງສາມາດປັບພະລັງງານເລເຊີໄດ້ແບບໄດນາມິກ (ຄວາມລະອຽດການປັບ: 0.1 mJ).
· ການປ້ອງກັນຜ້າມ່ານອາກາດຊ່ວຍຫຼຸດຜ່ອນຮອຍແຕກຂະໜາດນ້ອຍຂອງຂອບ (<3μm).
ໃນກໍລະນີການນຳໃຊ້ທົ່ວໄປທີ່ກ່ຽວຂ້ອງກັບການຫັ່ນແຜ່ນເວເຟີ sapphire ໜາ 0.5 ມມ, ລະບົບດັ່ງກ່າວບັນລຸຄວາມໄວໃນການຕັດ 300 ມມ/ວິນາທີ ດ້ວຍຂະໜາດການບิ่น <10μm, ເຊິ່ງເປັນຕົວແທນໃຫ້ແກ່ການປັບປຸງປະສິດທິພາບ 5 ເທົ່າ ເມື່ອທຽບກັບວິທີການແບບດັ້ງເດີມ.
ຂໍ້ໄດ້ປຽບໃນການປຸງແຕ່ງ
1. ລະບົບຕັດ ແລະ ແຍກສອງສະຖານີປະສົມປະສານສຳລັບການປະຕິບັດງານທີ່ມີຄວາມຍືດຫຍຸ່ນ;
2. ການເຄື່ອງຈັກຄວາມໄວສູງຂອງຮູບຮ່າງທີ່ສັບສົນຊ່ວຍເພີ່ມປະສິດທິພາບການປ່ຽນແປງຂະບວນການ;
3. ຂອບຕັດທີ່ບໍ່ມີຮູບຊົງແຫຼມທີ່ມີການບิ่นໜ້ອຍທີ່ສຸດ (<50μm) ແລະ ການຈັດການທີ່ປອດໄພຕໍ່ຜູ້ປະຕິບັດງານ;
4. ການຫັນປ່ຽນທີ່ລຽບງ່າຍລະຫວ່າງຂໍ້ມູນສະເພາະຂອງຜະລິດຕະພັນດ້ວຍການໃຊ້ງານທີ່ງ່າຍດາຍ;
5. ຄ່າໃຊ້ຈ່າຍໃນການດຳເນີນງານຕໍ່າ, ອັດຕາຜົນຜະລິດສູງ, ຂະບວນການທີ່ບໍ່ມີການບໍລິໂພກ ແລະ ບໍ່ມີມົນລະພິດ;
6. ບໍ່ມີການຜະລິດຂີ້ຕົມ, ນ້ຳເສຍ ຫຼື ນ້ຳເສຍທີ່ຮັບປະກັນຄວາມສົມບູນຂອງໜ້າດິນ;
ຕົວຢ່າງການສະແດງ

ຄໍາຮ້ອງສະຫມັກທົ່ວໄປ
1. ການຜະລິດເຄື່ອງໃຊ້ໄຟຟ້າສຳລັບຜູ້ບໍລິໂພກ:
· ການຕັດຮູບຮ່າງທີ່ຊັດເຈນຂອງກະຈົກຝາປິດໂທລະສັບສະຫຼາດແບບ 3D (ຄວາມຖືກຕ້ອງຂອງມຸມ R: ±0.01 ມມ).
· ການເຈາະຮູຂະໜາດນ້ອຍໃນເລນໂມງ sapphire (ຮູຮັບແສງຕໍ່າສຸດ: Ø0.3 ມມ).
· ການສຳເລັດຮູບເຂດສົ່ງສັນຍານແກ້ວອໍບຕິກສຳລັບກ້ອງຖ່າຍຮູບພາຍໃຕ້ຈໍສະແດງຜົນ.
2. ການຜະລິດອົງປະກອບທາງແສງ:
· ການເຄື່ອງຈັກໂຄງສ້າງຈຸນລະພາກສຳລັບອາເຣເລນ AR/VR (ຂະໜາດຄຸນສົມບັດ ≥20μm).
· ການຕັດມຸມຂອງປຣິຊຶມຄວດສ໌ສຳລັບເຄື່ອງວັດແທກເລເຊີ (ຄວາມທົນທານຂອງມຸມ: ±15").
· ການສ້າງຮູບຮ່າງໂປຣໄຟລ໌ຂອງຕົວກອງອິນຟາເຣດ (ການຕັດແບບເທບ <0.5°).
3. ການຫຸ້ມຫໍ່ເຄິ່ງຕົວນຳ:
· ການປະມວນຜົນດ້ວຍແກ້ວຜ່ານ (TGV) ໃນລະດັບແຜ່ນເວເຟີ (ອັດຕາສ່ວນ 1:10).
· ການແກະສະຫຼັກຊ່ອງຈຸລະພາກເທິງພື້ນຜິວແກ້ວສຳລັບຊິບຈຸລະພາກຟູລິອິດິກ (Ra <0.1μm).
· ການຕັດຄວາມຖີ່ໃນການປັບແຕ່ງສຳລັບເຄື່ອງສະທ້ອນສຽງ quartz MEMS.
ສຳລັບການຜະລິດປ່ອງຢ້ຽມແສງ LiDAR ສຳລັບລົດຍົນ, ລະບົບດັ່ງກ່າວຊ່ວຍໃຫ້ສາມາດຕັດຮູບຊົງຂອງແກ້ວ quartz ໜາ 2 ມມ ທີ່ມີມຸມຕັດຕັ້ງສາກ 89.5±0.3°, ຕອບສະໜອງຄວາມຕ້ອງການການທົດສອບການສັ່ນສະເທືອນລະດັບລົດຍົນ.
ຄໍາຮ້ອງສະຫມັກຂະບວນການ
ອອກແບບໂດຍສະເພາະສຳລັບການຕັດວັດສະດຸທີ່ແຕກຫັກງ່າຍ/ແຂງຢ່າງແມ່ນຍຳ ລວມທັງ:
1. ແກ້ວມາດຕະຖານ ແລະ ແວ່ນຕາແສງ (BK7, ຊິລິກາປະສົມ);
2. ຜລຶກຄວດສ໌ ແລະ ຊັ້ນຮອງແກ້ວໄພລິນ;
3. ແກ້ວປ້ອງກັນຄວາມຮ້ອນ ແລະ ຕົວກອງແສງ
4. ຊັ້ນໃຕ້ດິນກະຈົກ
ສາມາດຕັດຮູບຊົງ ແລະ ເຈາະຮູພາຍໃນໄດ້ຢ່າງແມ່ນຍຳ (ຕໍ່າສຸດ Ø0.3 ມມ)
ຫຼັກການຕັດເລເຊີ
ເລເຊີສ້າງກຳມະຈອນທີ່ສັ້ນຫຼາຍດ້ວຍພະລັງງານສູງຫຼາຍທີ່ພົວພັນກັບຊິ້ນວຽກພາຍໃນໄລຍະເວລາ femtosecond-to-picosecond. ໃນລະຫວ່າງການແຜ່ລາມຜ່ານວັດສະດຸ, ລຳແສງຈະລົບກວນໂຄງສ້າງຄວາມກົດດັນຂອງມັນເພື່ອສ້າງຮູ filament ຂະໜາດໄມຄຣອນ. ໄລຍະຫ່າງຮູທີ່ດີທີ່ສຸດສ້າງຮອຍແຕກຂະໜາດນ້ອຍທີ່ຄວບຄຸມໄດ້, ເຊິ່ງລວມກັບເທັກໂນໂລຢີການຕັດເພື່ອໃຫ້ໄດ້ການແຍກທີ່ຊັດເຈນ.
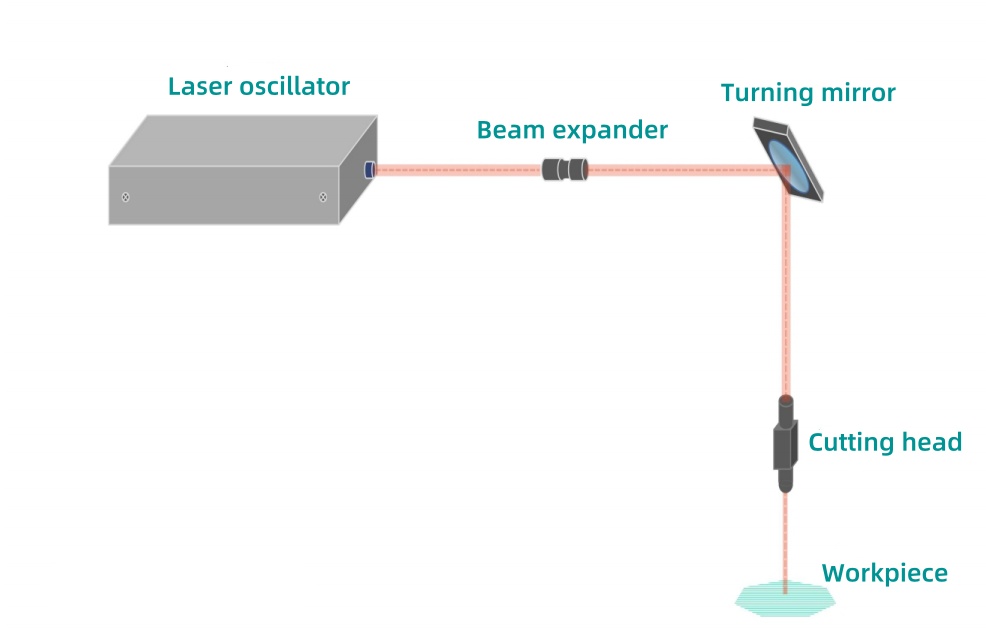
ຂໍ້ດີຂອງການຕັດເລເຊີ
1. ການເຊື່ອມໂຍງອັດຕະໂນມັດສູງ (ລວມຟັງຊັນການຕັດ/ການຕັດ) ດ້ວຍການໃຊ້ພະລັງງານຕໍ່າ ແລະ ການດໍາເນີນງານງ່າຍດາຍ;
2. ການປະມວນຜົນແບບບໍ່ຕິດຕໍ່ເຮັດໃຫ້ມີຄວາມສາມາດພິເສດທີ່ບໍ່ສາມາດບັນລຸໄດ້ຜ່ານວິທີການແບບດັ້ງເດີມ;
3. ການດຳເນີນງານແບບບໍ່ໃຊ້ວັດສະດຸບໍລິໂພກຊ່ວຍຫຼຸດຜ່ອນຄ່າໃຊ້ຈ່າຍໃນການດຳເນີນງານ ແລະ ເສີມຂະຫຍາຍຄວາມຍືນຍົງດ້ານສິ່ງແວດລ້ອມ;
4. ຄວາມແມ່ນຍໍາທີ່ດີກວ່າດ້ວຍມຸມ taper ສູນ ແລະ ການກໍາຈັດຄວາມເສຍຫາຍຂອງຊິ້ນວຽກທີສອງ;
XKH ໃຫ້ບໍລິການປັບແຕ່ງທີ່ສົມບູນແບບສຳລັບລະບົບຕັດເລເຊີຂອງພວກເຮົາ, ລວມທັງການຕັ້ງຄ່າແພລດຟອມທີ່ເໝາະສົມ, ການພັດທະນາຕົວກໍານົດການຂະບວນການພິເສດ, ແລະວິທີແກ້ໄຂສະເພາະຂອງແອັບພລິເຄຊັນເພື່ອຕອບສະໜອງຄວາມຕ້ອງການການຜະລິດທີ່ເປັນເອກະລັກໃນອຸດສາຫະກໍາຕ່າງໆ.




